【プレスリリース】高輝度放射光で解き明かすシリコン酸化膜の成長過程 — ナノデバイスの世界を支配する界面欠陥とキャリア捕獲 —お知らせ
発表のポイント
- 半導体デバイスの作製には、酸化反応を制御し、欠陥の少ない良質なシリコン酸化膜を作製することが不可欠。しかし、ナノレベルの薄膜領域におけるシリコン酸化反応機構の理解は不十分。
- シリコン表面に極薄酸化膜が成長する過程をSPring-8の放射光を用いてリアルタイム観察。その結果、酸化膜とシリコン基板の界面にある欠陥で酸素分子が反応する時、シリコン基板のキャリアが関与することを発見。
- 本成果は、シリコンを用いた半導体デバイスの省電力化、小型化、信頼性向上に貢献。
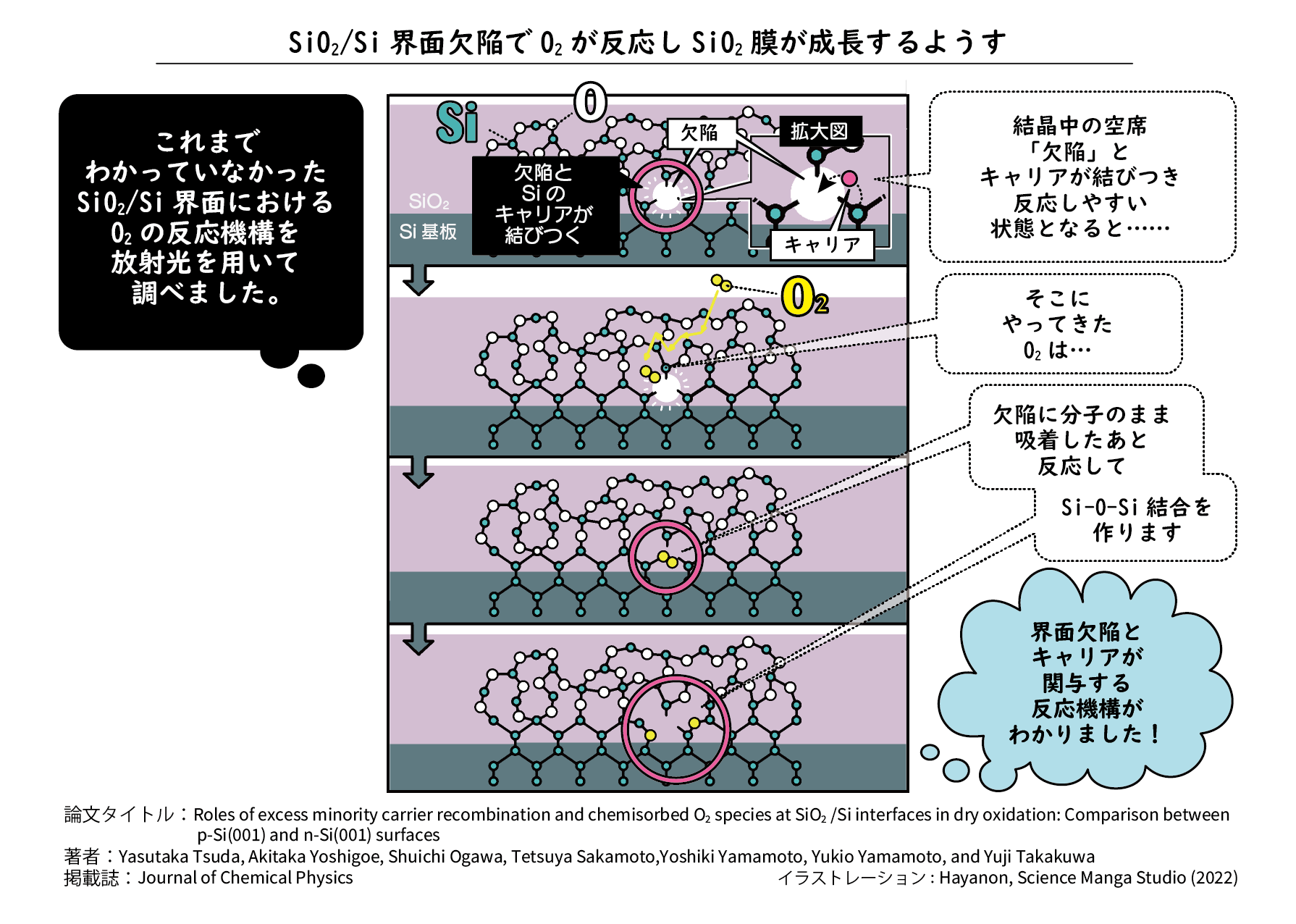
概要
詳細な説明
コンピュータやスマートフォンなどの情報機器は、Siを基板とした半導体デバイスによって制御されており、その計算処理性能は、集積回路(IC)中におけるトランジスタの数で決まります。Si基板上にトランジスタを構成する重要なプロセスの一つが、酸素(O2)ガスにさらし酸化膜を成長させることでゲート絶縁膜と呼ばれる部位を作製することです。近年、IC中のトランジスタ数は数十億個に達しており、非常に小さなトランジスタをSi基板上に構成しなくてはいけません。そのためにはゲート絶縁膜としておよそ1nmレベルの酸化膜を作ることが不可欠です。これほどの薄さでは、わずかな欠陥(原子の抜けてできた穴)が、消費電力の増加や誤動作を引き起こすなどの問題があるため、欠陥の少ない良好な絶縁膜を作製するために、酸化反応を理解し制御する必要があります。しかし、このような非常に薄い膜厚領域において、酸化膜の成長を支配する反応機構は十分に理解されていませんでした。
本研究では、大型放射光施設SPring-8注3(兵庫県佐用町)の原子力機構専用ビームラインBL23SUを利用し、Si表面の酸化反応をX線光電子分光法注4という手法で調べました。高輝度、高分解能の放射光により高速でデータを取得することで、酸化反応が進み化学状態が変化していく様子をリアルタイムで観察することができます。
Si基板上における酸化膜すなわちSiO2の成長は、酸化膜表面からO2が取り込まれて内部に拡散していき、SiO2/Si界面で反応するという流れで進行します。これまで、SiO2/Si界面でのO2の反応は、Si-Si結合とO2が直接反応しSi-O-Si結合を生成するという流れで起こると考えられていました。一方で、このような反応にはO2が高い運動エネルギーをもつ必要があることも知られています。O2ガスによる酸化ではO2分子のもつ平均運動エネルギーは低いため、この説明は矛盾しています(図1(a))。
本研究では、SiO2/Si界面における欠陥に着目しました。SiO2/Si界面ではSiO2生成にともなう体積膨張のため、大きな歪みがかかっています。この歪みにより界面では欠陥の生成が引き起こされることが知られています(図2)。我々はこれまでの研究で、この欠陥でO2が反応していることをつきとめました(関連文献)。しかし、どのように欠陥で反応が起こっているかは不明のままでした。この点に関し、欠陥にキャリアが結びつくことで化学的に反応がしやすい状態となり、O2と反応するのではないかと予想し、放射光を用いたリアルタイム光電子分光測定により実証しました。さらに、生じた反応しやすい欠陥において、O2が分子のまま吸着することを見出しました。その後O2はO原子に解離し、Si-O-Si結合を形成します。このような分子状吸着を介する反応経路はエネルギーを必要としません(図1(b))。よって、上記のような矛盾は起こらず、実験事実を自然に説明することができました。
以上のように、SiO2/Si界面におけるO2の反応は欠陥での分子状吸着を介したプロセスで進行し、その反応過程でSi基板のキャリアが関与するという新しい反応メカニズムを提案しました。


SPring-8の放射光を用いた本研究により、Siの酸化反応を原子レベルで初めて明らかにしました。本研究の酸化モデルは様々な応用が期待されます。例えばこれまで不明であったp型Siとn型Siで酸化速度が異なる理由を説明できます。このことは、今後も重要な役割を担うCMOS注5の設計、製造プロセスで不可欠な基盤技術の確立につながります。また、欠陥でO2が反応することを示した本成果は、欠陥を消滅させながらSiO2成長が可能であることを示唆しています。よって、欠陥の少ない良好なゲート絶縁膜を実現し、デバイスの高性能化につながります。また、近年のトランジスタでは、酸化ハフニウム(HfO2)のようにSiO2よりも高い比誘電率注6をもつ材料(high-k材料)をゲート絶縁膜に用いる手法も使われています。しかしその場合でも、1nm程度のSiO2をHfO2膜とSi基板の間に形成することで欠陥の少ない界面が実現されることが知られています。したがって、本研究はそのようなhigh-k材料を利用したデバイス作製においても重要な成果です。
以上のように本研究を応用することで、デバイスの省電力化、信頼性向上、さらなる高密度集積化による小型化や高性能化などが期待されます。
各研究者の役割は以下の通りです。
津田泰孝(原子力機構(MSRC)):研究計画立案、放射光実験の実施、データ解析、実験装置・測定システムの高度化、実験結果の考察
吉越章隆、坂本徹哉(原子力機構(MSRC)):放射光実験の実施、実験装置・測定システムの高度化、実験結果の考察
小川修一(東北大学):放射光実験の実施、データ解析システムの構築、実験結果の考察
山本幸男、山本善貴(福井高専):実験装置・測定システムの高度化
髙桑雄二(東北大学):研究計画立案、放射光実験の実施、実験結果の考察
論文情報
雑誌名: Journal of Chemical Physics
論文題名: “Roles of excess minority carrier recombination and chemisorbed O2 species at SiO2 /Si interfaces in dry oxidation: Comparison between p-Si(001) and n-Si(001) surfaces”
著者名: Yasutaka Tsuda1, Akitaka Yoshigoe1, Shuichi Ogawa2, 3, Tetsuya Sakamoto1, Yoshiki Yamamoto4, Yukio Yamamoto4, and Yuji Takakuwa1, 5
所属: 1日本原子力研究開発機構物質科学研究センター(MSRC)、2東北大学国際放射光イノベーション・スマート研究センター、3東北大学多元物質科学研究所、4福井工業高等専門学校、5東北大学マイクロシステム融合研究開発センター
“Roles of strain and carrier in silicon oxidation”
Shuichi Ogawa, Akitaka Yoshigoe, Jaiyi Tang, Yuki Sekihata, Yuji Takakuwa, Japanese Journal of Applied Physics, 2020, 59, SM0801
用語説明
信号の増幅や回路のオン・オフにより電気信号を制御する半導体素子の一つです。特に、半導体基板と酸化膜、金属電極から構成される金属-酸化膜-半導体 電界効果トランジスタ (metal-oxide-semiconductor field-effect transistor: MOSFET)が集積回路などでは一般的に使用されます。
半導体内部で電気の伝導に寄与する電子(負電荷)および正孔(正電荷)のことです。Siなどの半導体は、キャリアを発生させることのできる不純物を添加(ドーピング)することで物理的特性を制御することができます。主に電子がキャリアとなる半導体はn型半導体、主に正孔がキャリアとなる半導体はp型半導体と呼ばれます。
兵庫県の播磨科学公園都市にある世界最高性能の放射光を生み出す理化学研究所の施設で、SPring-8の名前はSuper Photon ring-8 GeV(ギガ電子ボルト)に由来します。放射光とは、電子を光とほぼ等しい速度まで加速し、電磁石によって進行方向を曲げた時に発生する、指向性が高く強力な電磁波のことです。SPring-8では、この放射光を用いて、ナノテクノロジーやバイオテクノロジー、産業利用まで幅広い研究が行われています。
物質の表面にX線などのエネルギーの大きな光を照射すると、表面から電子が飛び出してきます。この電子を光電子と呼びます。飛び出してくる光電子の速度は、物質の表面近くの状態に依存するため、光電子の速度を測定することで表面の化学状態を知ることができます。このような方法をX線光電子分光法と呼びます。
相補型金属酸化膜半導体(Complementary Metal-Oxide-Semiconductor)。上記のMOSFETを改良したものであり、p型とn型2種類のMOSFETを組み合わせた構造をもちます。MOSFETと比較すると動作速度が速く、消費電力が小さいという特徴があります。p型Siとn型Siを同時に酸化して作製されます。
物質に電場を加えた時、物質内部の電荷分布に偏りが生じます(誘電分極)。誘電分極の起こりやすさを表す物理量を誘電率と呼び、真空の誘電率に対する比をとったものが比誘電率です。比誘電率の高い物質ほどゲート絶縁膜を薄く作製した際の電流リークが起こりにくいため、SiO2に代わる材料として期待されています。また、比誘電率は記号kであらわされるため、比誘電率の高い材料はhigh-k材料とも呼ばれます。
関連リンク
問い合わせ先
【研究に関すること】
教授 髙桑雄二
E-mail: yuji.takakuwa.b7*tohoku.ac.jp
助教 小川修一
TEL: 022-217-5367
【報道に関すること】
教授 戸津健太郎
TEL: 022-229-4113,
E-mail: kentaro.totsu.e4*tohoku.ac.jp
TEL: 022-217-5198
※E-mailは*を@に置き換えてください。
お問い合わせ
東北大学 国際放射光イノベーション・スマート研究センター
〒980-8572 仙台市青葉区荒巻字青葉468−1


